摘要:
本文选取目前发现的能够在最接近室温的条件下产生金属–绝缘转变(MIT)的氧化物功能材料VO
2薄膜为研究对象,探究表面重构的斜切a面蓝宝石基底对VO
2薄膜结构与性质的调控作用。通过高温退火处理使朝[0001]方向斜切0˚、1˚、3˚的a面蓝宝石基底表面重构,并用原子力显微镜观察到斜切基片重构后表面形成峰–谷形状的沟槽。使用脉冲激光沉积法在斜切基片上制备VO
2薄膜,XRD表征显示成功制备了外延的VO
2薄膜。为了精确表征朝[0001]方向的不同斜切角度的a面蓝宝石基片上VO
2薄膜晶格常数的变化,分别在面内与面外进行了倒空间扫描并计算了VO
2薄膜的晶格常数。倒空间结果表明斜切0˚的基片为VO
2薄膜引入应变。通过范德堡法测试了朝[0001]方向斜切基片上的VO
2薄膜的电阻,朝[0001]方向斜切的基片上获得了高度应变的薄膜,随着相变温度的升高,调控了MIT的性能。
Abstract:
VO2 is a kind of oxide functional materials with unique metal-insulator transitions (MITs) near room temperature. In this paper, we explore the roles of surface-reconstructed a-plane sapphire substrates on their structure and properties. The microstructures on a-plane sapphire substrates formed by 0˚, 1˚ and 3˚ miscut along with [0001]. The surface of the sapphire will be reconstructed after annealing, and the surface step terrances will be formed on the sapphire surface. The pulsed laser deposition was used to grow VO2 films on the a-plane sapphire substrates. XRD was used to characterize the structural properties of the films. XRD results show that we have prepared epitaxial VO2 films on a-plane sapphire substrates. The reciprocal space mapping (RSM) results show that the a-plane sapphire without miscut introduces strains into the films. The changes in VO2 film resistances with various temperatures are studied by van der pauw method. The results show that the phase transition temperature is increased with the interfacial strain, which would tune MIT. These results open the ways for exploring and designing heteroepitaxial materials for nanoelectronic devices.
1. 引言
近年来,无机材料的电学性质一直是人们研究的重点,成功控制无机材料的电学性质,将对储能、能量转换和能源利用等方面的应用意义重大。钒氧化物的MIT性能在智能窗户和磁热制冷机的能源利用方面也有着巨大的优势 [1]。薄膜制备方法有脉冲激光沉积、磁控溅射、溶胶–凝胶法、分子束外延、化学气相沉积等。研究者们利用脉冲激光沉积法在蓝宝石基片上制备出外延的VO2薄膜 [2]。界面效应在调控薄膜的外延性质和物理性能方面起着关键作用。薄膜生长会受薄膜与基片晶格错配引起的应变、台阶高度和台阶尺寸等因素的影响 [3]。邹崇文等人的研究表明外延薄膜中的应变可以调控VO2薄膜的电子结构 [4]。Aetukuri 等人在TiO2(001)基片上外延生长VO2薄膜,通过改变缓冲层的厚度来导致不同外延应变,发现VO2薄膜MIT临界转变温度就会下降到室温(300 K)附近 [5]。Lu和Kittiwatanakul 等人在TiO2基片上外延生长的VO2 薄膜中观察到了电阻的各向异性,在TiO2(011)生长的样品中,通过在垂直于基片<001>和平行于基片<001>的两个方向上测电阻,在TiO2(001)基片上生长的样品中,通过在基片的<100>和<010>的两个方向上测电阻,发现不同方向测得的电阻存在差异 [6] [7]。我们发现经过退火处理的斜切a面蓝宝石表面会形成台阶微结构,想通过台阶微结构调制在其表面外延薄膜的物理性质。目前,已经证明VO2薄膜可以在蓝宝石(0001)基底上实现外延生长 [8]。那么VO2薄膜能否在a面蓝宝石上实现外延生长这关系到我们实验的可行性。研究表明VO2薄膜可以在a面蓝宝石上沿着(100)取向生长 [9] [10]。这表明我们选用a面蓝宝石作为模版是合适的。本文在重构a面蓝宝石基底上生长VO2薄膜,分别在经过退火处理的斜切0˚的a面蓝宝石以及朝[ 0001 ]方向斜切1˚,3˚的a面蓝宝石上生长VO2薄膜,探究斜切基片对VO2薄膜金属–绝缘相变性能的调控作用。
2. 实验
2.1. 二氧化钒薄膜的制备
在进行实验之前,我们对不同斜切角度的a面蓝宝石基底表面进行重构。将斜切0˚的a面蓝宝石以及朝[ 0001 ]方向斜切的a面蓝宝石基底(尺寸为10 × 10 × 0.5 mm)用乙醇超声清洗5 min,然后用丙酮超声清洗25 min,最后再用异丙醇清洗5 min。清洗完成以后将三种基底吹干,然后放入KSL-1500X箱式炉中进行退火,以10℃/min的升温速率升至 1400℃,在1400℃下保持24 h,然后再以5℃/min降到室温。在制备VO2薄膜之前,我们先将重构的a面蓝宝石基底用原子力显微镜进行表征(型号为牛津仪器公司的MFP-3D)。我们采用脉冲激光沉积技术(PLD)制备VO2薄膜,使用的靶材为V2O3。将重构后a面蓝宝石基底放入真空腔中,背地真空抽至8 × 10−4 Pa,腔内温度升至630℃,反应气氛稳定在氧气1.3 Pa后开始沉积,沉积能量为260 mJ,频率为2 HZ。
2.2. 二氧化钒薄膜的表征
为保持VO2薄膜表面的洁净,我们首先对制备的VO2薄膜表面进行表征。利用原子力显微镜(AFM,型号为MFP-3D-SA)表征其表面。采用X射线衍射仪(XRD,型号为Panalytical Empyrean)分析薄膜结晶取向。为了分析VO2金属–绝缘相变特性,最后还需通过范德堡法测试薄膜的电阻。
3. 结果与讨论
在制备VO2薄膜之前,我们首先用原子力显微镜对重构后的蓝宝石表面进行表征。图1(a)为a面蓝宝石朝[000l]方向斜切3˚的基片表面形貌,可以看出经过退火以后,样品表面形成沟槽结构。我们对斜切0˚以及斜切1˚的a面蓝宝石基底进行同样工艺的退火处理,将处理过的基片用原子力显微镜进行表征,发现斜切0˚的样品未能测出沟道,而斜切1˚的样品虽然可以测出沟道,但是非常不清晰。图1(b)是图1(a)所在区域的三维效果图,从图中我们可以清楚看出,经过退火处理后,a面蓝宝石朝[000l]方向斜切3˚的基片表面形成峰–谷结构,沟槽的深度为3到4个纳米,沟槽的宽度为75个纳米左右。我们用脉冲激光沉积法制备VO2薄膜,图1(c)是朝[000l]方向斜切3˚的a面蓝宝石上的VO2薄膜的表面形貌,制备的薄膜的厚度约为20 nm,粗糙度为13.7 nm,薄膜表面起伏非常小,较为平整。

Figure 1. (a) Reconstructed a-plane sapphire surface topography of MISCUT 3; (b) 3D rendering of sapphire surface; (c) Surface morphology of VO2 film on a-plane sapphire substrates formed by 3˚ miscut along with [ 0001 ]
图1. (a) 重构斜切3˚a面蓝宝石表面形貌;(b) 蓝宝石表面三维效果图;(c) 朝[000l]方向斜切3˚的a面蓝宝石上的VO2薄膜的表面形貌
为了研究斜切基片对VO2薄膜的性能调控作用,我们使用同样的工艺在不同斜切角度的a面蓝宝石基片上制备了VO2薄膜。首先使用X射线衍射仪(XRD)对VO2薄膜的结晶取向进行分析,图2(a)是朝[ 0001 ]方向斜切的a面蓝宝石基片上生长的VO2薄膜的θ-2θ扫描结果,扫描结果表明我们制备的VO2薄膜是沿着[ 100 ]单一取向生长的。为了了解薄膜与基底之间的对称性关系,对面内VO2(
)以及a面蓝宝石(
)面进行Phi扫描,图2(b)是斜切0˚的a面蓝宝石基片上生长的VO2薄膜的Phi扫描,结果显示VO2薄膜具有二重对称性结构,而a面蓝宝石的(
)面的Phi扫描结果与其一致。因此,这表明我们成功使用脉冲激光沉积法在a面蓝宝石上制备出外延的VO2薄膜。根据以上所得计算晶面关系,得外延关系为:VO2(100)M1//Al2O3(
)和VO2(010)M1//Al2O3(0001)。

Figure 2. (a) Out-of-plane θ-2θ scans and; (b) Phi scans
图2. (a) 面外θ~2θ扫描衍射峰;(b) 面内晶格取向的phi扫描
为了精确的表征外延VO2薄膜的晶格常数,有必要对样品进行倒空间表征。倒空间扫描是在100℃下进行的,此时VO2薄膜处于高温金红石相。分别对朝[ 0001 ]方向斜切0˚、1˚、3˚的a面蓝宝石上制备的VO2薄膜进行倒空间扫描,图3是斜切1˚样品的倒空间扫描结果:在Al2O3(
)面附近观察到VO2薄膜(011)R的衍射斑点,在Al2O3(
)面附近观察到VO2薄膜(222)R的衍射斑点,在Al2O3(
)面附近观察到2个VO2薄膜的衍射斑点,分别为VO2薄膜(031)R的衍射斑点与(002)R的衍射斑点。为了简单起见,预先计算了[ 100 ] R、[ 010 ] R、[ 001 ]取向上的晶格常数即a、b、c。使用VO2(011)R和VO2(222)R平面的晶格常数,可以计算出a的值;b的值可以使用衍射点VO2(011)R和VO2(031)R平面的晶格常数计算出;同时,可以使用VO2(002)R平面的晶格常数直接计算c的值。表1给出了不同斜切角度的a面蓝宝石基底上的VO2薄膜晶格常数a、b、c的值。对于斜切0˚的a面蓝宝石基底上生长的VO2薄膜样品,经过计算:a0 = 4.5491 Å,b0 = 4.5614 Å,c0 = 2.8510 Å。粉体VO2中:a = 4.5546 Å,b = 4.5546 Å,c = 2.8514 Å。由此可见,a面蓝宝石基底为VO2薄膜引入应力:在[ 100 ] R取向上薄膜产生0.12%的压缩应变;在[ 010 ]R取向上薄膜产生0.14%的拉伸应变;在[ 001 ]R取向上薄膜产生0.01%的压缩应变。对于斜切1˚的基底上的VO2薄膜,经过计算:a1 = 4.5458 Å,b1= 4.5504 Å,c1 = 2.8518 Å。对于斜切3˚的基片上生长的VO2薄膜,经过计算:a3 = 4.5407 Å,b3 = 4.5552 Å,c3 = 2.8502Å。因此,对于斜切1˚的基底上的VO2薄膜:在[ 100 ]R取向上薄膜产生0.19%的压缩应变;在[ 010 ]R取向上薄膜产生0.09%的压缩应变;在[ 001 ]R取向上薄膜产生0.01%的拉伸应变。对于斜切3˚的基底上的VO2薄膜:在[ 100 ]R取向上薄膜产生0.30%的压缩应变;在[ 010 ]R取向上薄膜产生0.01%的拉伸应变;在[ 001 ]R取向上薄膜产生0.04%的压缩应变。对比斜切基片与斜切0˚的基片对VO2薄膜的应变状态,发现随着斜切角度的增加,在[ 100 ]R取向上薄膜应变逐渐增加。因此,对于斜切基片上的样品,除了受到基片为薄膜引入的正常应变以外,应该还受到一个切向应变,正是因为切向应变的存在,使得斜切基片生的薄膜受到的应变更大 [11]。

Figure 3. X-ray diffraction reciprocal space mapping results: (a) Reciprocal space mappings taken on the planes perpendicular to Al2O3[
] of MISCUT 1˚; (b) Reciprocal space mappings taken on the planes perpendicular to Al2O3[ 0001 ] of MISCUT 1˚
图3. XRD倒空间扫描结果斜切:(a) 垂直于Al2O3[
]取向的倒空间扫描(斜切1˚样品);(b) 垂直于Al2O3[ 0001 ]取向的倒空间扫描(斜切1˚样品)

Table 1. Lattice constants of VO2 films on a-plane sapphire substrates with different miscut angles
表1. 不同斜切角度的a面蓝宝石基底上的VO2薄膜晶格常数
通过斜切手段调控基片表面台阶微结构,进而调制在其表面外延薄膜,这样破坏了VO2薄膜的晶格对称性。利用Parkin等人描述的晶格与电子之间的强耦合,比率cR/aR决定了MIT的临界点,即cR/aR比值越大时VO2薄膜发生金属–绝缘相变时将会有更高的临界点以及更大的开关比 [12]。这表明影响相变温度的内在因素是晶格常数大小,基于此我们认为:
D的值决定了MIT的临界点。前面已经计算了a、b、c的值,因此计算出斜切0˚的基片生长的VO2薄膜其D0的值为0.626,斜切1˚的基片生长的VO2薄膜其D1的值为0.627,斜切3˚基片上生长的VO2薄膜其D3的值为0.627。因此预测斜切1˚与斜切3˚基片上生长的VO2薄膜发生金属–绝缘相变将会有更大的开关比以及更高的临界点。
如图4所示,由不同斜切角度的基片上生长的VO2薄膜电阻率与温度的关系曲线可以看出,斜切1˚与斜切3˚基片上生长的VO2薄膜表现出了4个数量级的开关比。没有斜切的(斜切0˚)的基片上生长的VO2薄膜表现出了2个数量级的开关比,这与我们的预测结果一致。图5是不同斜切角度的基片上生长的VO2薄膜电阻率与温度的
微分曲线,从图5可以看出:朝[ 0001 ]方向斜切0˚的a面蓝宝石基底上生长的VO2薄膜升温的相变点是67.7℃,降温的相变点是61.2℃,转变宽度为6.5℃;朝[ 0001 ]方向斜切1˚的a面蓝宝石基底上生长的VO2薄膜的升温相变点是69.0℃,降温的相变点是62.5℃,转变宽度为6.5℃;朝[ 0001 ]方向斜切3˚的a面蓝宝石基底上生长的VO2薄膜升温的相变点是69.6℃,降温的相变点是62.6℃,转变宽度为7℃。因此随着基片斜切角度的增加,VO2薄膜的相变点是增加的。对于斜切3˚的基片生长的VO2薄膜,其D的值最大,因此预测斜切3˚基片上生长的VO2薄膜发生金属–绝缘转化将会有更大的开关比以及更高的临界点,实验结果与我们预测的一致。然而我们发现,斜切1˚基底上生长的VO2薄膜与斜切3˚的基底上生长的VO2薄膜有相同的D值,虽然有相同的开关比但是临界点却不一样。
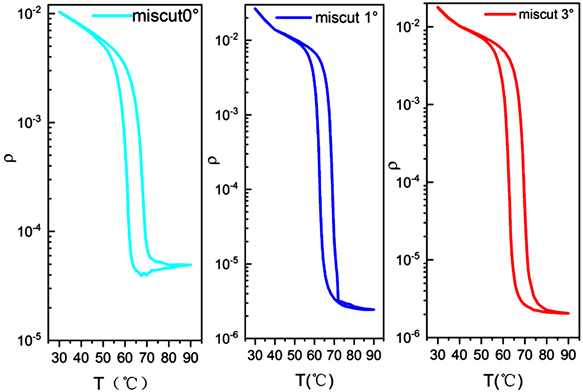
Figure 4. Resistivity vs. temperature curves
图4. 电阻率与温度的关系曲线

Figure 5. Differential curves of lnρ vs. temperature for heating (left) and cooling (right)
图5. 加热(左)和冷却(右)的lnρ与温度的微分
将斜切1˚基底上生长的VO2薄膜的晶格常数与斜切3˚的基底上生长的VO2薄膜的晶格常数进行对比,斜切3˚基片上的样品相较于斜切1˚基片上的样品有更大的应变,相变需要更大的潜热。但是两者的开关比又接近,因此斜切3˚的样品有更高的相变宽度,实际上斜切3˚的样品其相变宽度为7℃,而斜切1˚的样品其相变宽度为6.5℃。非掺杂的VO2薄膜的相变温度和薄膜体内的缺陷及受到的应力有关,因此VO2薄膜的相变温度的变化可能由多种情况导致。在朝[ 0001 ]方向斜切的基片上,由于随着斜切角度的增加,薄膜所受到的应变也随之增加,由于在朝[ 0001 ]方向斜切的基片上的电阻相变点随着斜切角度的增加而增加,说明VO2薄膜的相变温度受到斜切基片的调控,并且VO2薄膜的相变温度与朝[ 0001 ]方向的斜切角度成正相关。因此,朝[ 0001 ]方向斜切的基片上获得了高度应变的薄膜,随着相变温度的升高,调控了MIT的性能。
4. 结论
通过高温退火处理使朝[ 0001 ]方向斜切的a面蓝宝石基底表面重构,并用原子力显微镜观察到斜切基片重构后的表面形成峰–谷形状的沟槽。使用脉冲激光沉积法在斜切基片上制备VO2薄膜,XRD表征显示成功制备了外延的VO2薄膜。为了精确表征朝[ 0001 ]方向的不同斜切角度的a面蓝宝石基片上VO2薄膜晶格常数的变化,分别在面内与面外进行了倒空间扫描并计算了VO2薄膜面内面外的晶格常数,对比斜切基片与斜切0˚的基片对VO2薄膜的应变状态,发现随着斜切角度的增加,在[ 100 ]R取向上薄膜应变逐渐增加。因此对于斜切基片上的样品,除了受到基片为薄膜引入的正常应变以外,应该还受到一个切向应变,正是因为切向应变的存在,使得斜切基片生的薄膜受到的应变更大。通过范德堡法测试了朝[ 0001 ]方向斜切基片上的VO2薄膜的电阻,朝[ 0001 ]方向斜切的基片上获得了高度应变的薄膜,随着相变温度的升高,调控了MIT的性能。
参考文献
NOTES
*通讯作者。