1. 引言
金刚石拥有很多优良的理化性质,在热学方面,它具有最高的热导率和极低的热膨胀系数,是极佳的热沉材料。在力学领域,金刚石还是自然界中具有最高硬度的材料,因此,可以用它来制作精度优良的切削工具、耐磨部件以及钻头等,也是特殊材料的镜面加工刀具上必不可少的材料。此外,特别是在光学领域,金刚石从深紫外光区到远红外以及微波波段都具有高的透明性(除了在5 mm处由于自身存在的双声子振动而产生的微弱吸收峰之外) [1],使得金刚石成为理想的高功率红外激光窗口和整流罩材料 [2],近些年,经研究发现,金刚石在太赫兹领域也有很好的应用 [3]。与热丝化学气相沉积(HFCVD)和直流等离子体喷射化学气相沉积(DC-PJCVD)等制备方法相比,微波等离子体化学气相沉积(MPCVD)由于具有无极放电、等离子体密度高及分布均匀等优点被认为是制备光学金刚石膜的理想方法 [4]。目前国内外通常采用频率为915 MHz的高功率MPCVD装置制备金刚石膜,如德国的Fraunhofer研究所的椭球腔装置 [5],日本大阪大学的圆柱腔装置 [6],北京科技大学的圆柱腔装置 [7],而对采用频率为2450 MHz且功率高于十千瓦的高功率MPCVD装置来制备金刚石膜的工艺研究还鲜有报道。我们采用自主设计的功率为15 kW、频率为2450 MHz的高功率MPCVD装置进行制备金刚石膜,采用光学发射光谱法(OES)检测等离子体中和金刚石膜生长密切相关的C2基团和原子氢,采用Raman光谱仪表征金刚石膜质量,研究气压和甲烷体积分数对金刚石膜沉积速率和质量的影响。探索出一套适合于该装置沉积金刚石膜的工艺参数,并在微波功率为12 kW,气压为14 kPa,基片温度为850℃,CH4体积分数为1%的工艺条件下制备出直径为2英寸、厚度为1.6 mm的高质量金刚石膜。
2. MPCVD金刚石膜制备装置
本研究中采用的MPCVD装置原理图如图1所示。该装置配备的微波源频率为2450 MHz,其最大输出功率为15 kW,其主要特点是用于真空密封的石英窗被放置在铜台的下面,不会与样品台上的等离子球直接接触,这使得沉积的金刚石膜不会被污染。同时在沉积室内前、后、左、右四个方向都设计了一个同样大小的抽气孔,这样可保证腔体内各处气流分布更均匀,整个沉积室外壳和腔体内的铜台都采取水冷,使得装置即使在高功率微波条件下工作,也不会由于温度过高而影响整套装置正常运行。
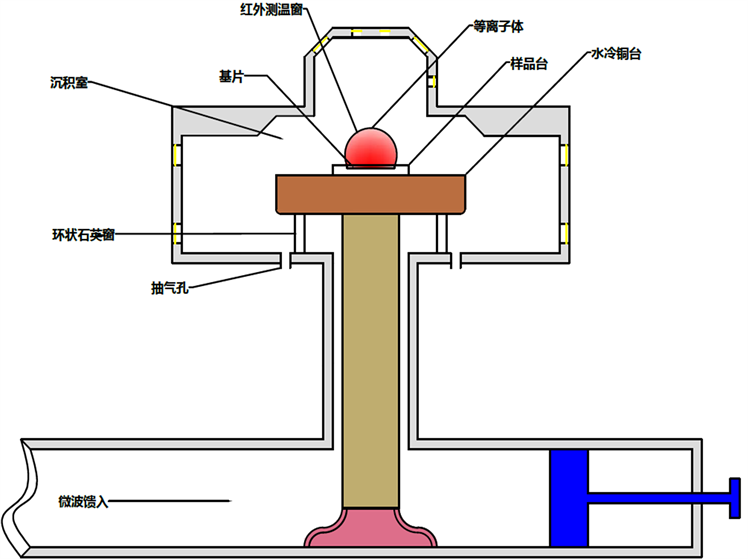
Figure 1. Schematic of the 15-kW MPCVD equipment
图1. 15 kW MPCVD装置原理图
3. 金刚石膜的制备与表征
3.1. 基片预处理
金刚石膜生长前需先在基片表面形核,本研究中选用浙江开化立晶硅材料公司生产的厚度为3 mm的多晶硅硅片为基片,为了有利于金刚石在多晶硅基片上形核,首先采用标准的机械划痕结合纳米金刚石粉超声的方法处理硅基片,具体如下:将多晶硅硅片采用粒度为0.5 μm的金刚石粉进行研磨,直到硅片上出现致密均匀的划痕,通常表现为硅片的研磨面出现均匀的蓝紫色光,此时表明硅片已研磨好。再将研磨好的硅片置于无水乙醇(纯度 ≥ 99.7%)和粒度为2 μm金刚石粉末配制成的悬浮液中超声清洗30 min,其中预处理中使用的金刚石粉来自于贵州第六砂轮厂,无水乙醇产自江苏强盛功能化学股份有限公司。然后取出硅片清洗干净并吹干后放入沉积腔内的样品台上备用。
3.2. 金刚石膜沉积前期工作
在腔体中放入基片,开始抽取真空,直到真空值达到可沉积的范围(−1 × 10−4 kPa);在这过程中同时打开腔体的冷却系统,打开微波电源开关,开启灯丝预热,将气体打开,以备起辉和沉积时使用。
3.3. 金刚石膜的沉积
在腔体真空达到沉积要求后,向腔体内通入1000 sccm流量的氢气(纯度为99.999%),调节气路中的球阀开关,使腔体内气压值维持在3 kPa (起辉气压),设定微波输出功率值为1 kW,然后启动高压按钮进行起辉,在这过程中逐渐调节氢气的流量和微波输出功率,使功率与气压值相互匹配,生成稳定的等离子体;当硅基片温度达到750℃左右,此时硅片呈砖红色,通入60 sccm的CH4 (纯度为99.999%)形核30 min,实验中使用的氢气和甲烷气体均产自于法国液化空气公司成都分公司;形核结束后,改变CH4的流量值,保持甲烷体积分数、微波输出功率、工作气压和基片温度稳定,进行长时间金刚石膜的沉积。
3.4. 测试与表征
采用Ocean Optics公司的Maya2000高灵敏度背照式FFT-CCD光谱仪来检测等离子体的内部参数,其可测量范围为200~1100 nm,光学分辨率为0.035 nm。用InVia型激光Raman光谱仪(Reinshaw公司)分析金刚石膜的物相纯度,其中激发光波长为514.5 nm,分辨率为0.5 cm−1。
4. 结果与讨论
4.1. 等离子体的光谱分析
在金刚石膜沉积过程中,光学发射谱(OES)常用来诊断等离子体中参与反应的各类化学基团,是一种重要的检测手段。图2分别是纯氢气(a)和氢气/甲烷混合气体(b)的等离子体发射光谱图。工作气压为9 kPa、输出功率为10 kW时的光谱图中,在486.1 nm和656.3 nm波长处非常明显地出现了Hβ和Hα两条谱线,同时也发现在434.0 nm波长处还有一个十分微弱的Hγ谱线,见图2(a)。一般在传统的低功率MPCVD装置中Hγ基团很少出现,只有在微波功率密度很高的情况下才能生成 [8],表明本装置在高微波功率输出时,对腔体内氢气分子激化非常充分。

Figure 2. Optical emission spectrum of the plasma in pure hydrogen (a) and H2+CH4 (b) atmosphere
图2. 气氛为纯氢气H2(a)和H2+CH4 (b) 时等离子体的光学发射光谱
图2(b)是在氢气中通入3%浓度的甲烷后,工作气压为13 kPa、输出功率为12 kW时生成等离子体的光学发射光谱图,图中除了原子氢的特征谱线外,还出现了CH、C2等含碳基团的谱线,这些基团的出现,说明CH4在等离子体中发生分解,图谱中分别在473.7 nm、516.5 nm、558.5 nm处出现的C2基团,和原子氢一样,是合成CVD金刚石的重要组成 [9] [10]。
在微波等离子体化学气相沉积金刚石膜的过程中,等离子体里生成的C2基团浓度通常作为CH4离解程度的一个重要参考,等离子体中C2基团浓度越高,表明甲烷离解率越高,甲基浓度也会越高,金刚石沉积速率也会增加 [11]。研究发现等离子体中C2和原子氢的相对强度比值(IC2/IHa)对金刚石膜的沉积质量有重要影响,通常在一定条件下IC2/IHa值越小,沉积的金刚石膜质量越高 [12]。图3分别是IC2/IHa值在不同的气体压强(Pr)、甲烷体积比(CH4%)情况下的变化趋势。在功率为13.5 kW、CH4体积分数为2%时,逐步提高腔体内沉积气体Pr值,C2/Ha的值也逐渐提高,当腔体内压强增加到14 kPa后,IC2/IHa的增长趋势趋于平缓,见图3(a),这表明在固定的微波输出功率条件下,气体在有限的能量中已经得到充分离解,通过进一步提高腔体内气压,等离子体中的C2基团已趋于饱和,不会大幅增长。图3(b)是微波功率为13.5 kW、Pr为13 kPa时IC2/IHa随甲烷体积分数变化的趋势,当气体中甲烷含量过低,等离子体中处于原子氢过饱和状态,含碳基团的浓度很低,会影响金刚石膜的生长速度和质量,在微波功率和气压一定的条件下,随着甲烷体积分数的增加,等离子体中C2/Ha的值明显增大,这会使金刚石膜的沉积速度提高,但也会降低金刚石膜的品质,因此甲烷含量需要保持在一个合适的值。

Figure 3. The curve of IC2/IHa in different gas pressure (a) and CH4 volume fraction (b)
图3. C2和Ha的相对强度比值在不同气体压强(a)和CH4体积分数(b)条件下的变化曲线
4.2. 金刚石膜的沉积速率和质量分析
对不同生长工艺条件下金刚石膜的厚度进行测试,来计算金刚石膜的生长速率。在功率为12 kW,沉积气压为12 kPa时,金刚石膜的沉积速率为6.02 um/h;沉积气压为14 kPa时,沉积速率为9.85 um/h;沉积气压为15 kPa时,沉积速率10.62 um/h;在功率一定且甲烷体积比为1%的条件下,随着沉积气压的增大,金刚石膜的生长速率也会增加,当气压达到14 kPa后,此时继续提高气压,而金刚石膜的生长速率增长放缓,与图3中基团谱线相对强度比值随气压改变时的变化趋势一致。图4是在不同气压条件下沉积金刚石膜的拉曼光谱图。图中可以看出,所有样品除了在1332 cm−1处出现了一个尖锐的金刚石特征峰外,均没有其它Raman共振峰出现,表明在该气压条件下生成的金刚石具有较好的纯度。金刚石膜的Raman特征峰的半高宽(FWHM)长被用来表征金刚石膜的结晶质量,FWHM值越小,金刚石膜的结晶质量越好 [13]。在功率为12 kW,甲烷体积比是1%,气压为12 kPa、14 kPa和15 kPa条件下沉积金刚石膜的Raman峰的FWHM值分别是8.04 cm−1、6.96 cm−1、和8.50 cm−1,这些金刚石膜具有很高的结晶质量,特别是在14 kPa时,本装置沉积的金刚石膜结晶质量最优,通过分析这是由于在该气压下,甲烷气体离解更充分,同时原子氢刻蚀作用增强,使得沉积的金刚石膜质量更高。

Figure 4. Raman spectra of diamond films deposited at CH4 volume fraction of 1% and gas pressures of 12 kPa (a), 14 kPa (b) and 15 kPa (c)
图4. 在1%CH4体积分数,压强为12 kPa(a),14 kPa(b)和15 kPa(c)条件下沉积的金刚石膜Raman光谱图
在功率12 kW、气压14 kPa的条件下,采用不同的CH4体积分数来沉积金刚石膜,其比例分别是1%、2%和3%,此时金刚石膜的沉积速率分别是9.85 um/h、13.47 um/h和16.82 um/h,随着CH4体积分数的增加,金刚石膜的沉积速率明显提高。图5分别是不同CH4体积分数条件下沉积的金刚石膜的Raman光谱图,三个样品的Raman光谱图中在1332 cm−1处都出现了金刚石特征峰,然而,随着CH4体积分数的提高到2%时,金刚石膜对应的Raman谱上在1580 cm−1处出现了石墨特征峰,见图5(b),表明此时的金刚石膜中含有较高含量的石墨相,金刚石膜的纯度开始降低;图5(c)中,当CH4体积分数为3%时,此时Raman光谱中出现了一个非常明显的石墨特征峰,而金刚石特征峰已经很弱,表明金刚石膜中的石墨含量已经非常高,同时样品的Raman图中还存在一个强烈的荧光背景,说明金刚石膜中还存在大量的缺陷 [14],金刚石膜的质量很低。

Figure 5. Raman spectra of diamond films deposited at CH4 volume fraction of 1% (a), 2% (b) and 3% (c)
图5. CH4体积分数为1%(a),2%(b),3%(c)条件下沉积金刚石膜的Raman光谱图
4.3. 金刚石膜的制备
基于以上研究,优化工艺参数后,采用本装置制备金刚石膜,经过长时间的沉积,制备出直径为2 inch,厚度达到1.6 mm的金刚石膜,工艺参数见表1:

Table 1. Process parameters for depositing diamond films
表1. 沉积金刚石膜的工艺参数
采用拉曼光谱对沉积的CVD金刚石膜质量进行表征,图6(a)是采用上述工艺条件生长的金刚石膜的Raman光谱图。从图中可以看出,除了在1332.6 cm−1处出现了一个尖锐的sp3杂化的金刚石相一阶Raman共振峰以外,在整个1000~1800 cm−1范围内,均未见其他任何Raman共振峰,该Raman共振峰的半高宽长为6.96 cm−1,这表明采用上述工艺制备的金刚石膜具有很高的纯度和结晶质量。
图6(b)是沉积的金刚石膜样品图片,这是典型的微米晶金刚石膜,由于不同取向的晶粒之间的竞争生长,只有具有更快生长速度的晶粒能够继续长大,这种“竞争选择”效应随着生长时间长、膜片更厚,组成整块金刚石膜的晶粒尺寸也很大,可达到数十微米,金刚石膜表面的粗糙度也增大 [15]。可以看见该膜晶粒尺寸均匀,经测量,表面平整度为2.5%,膜片边沿处比中间处略高,这是由于基片在等离子体中产生了一种“边沿放电”效应 [16],该效应会让硅片边沿产生很强的等离子体放电现象,生成更高等离子体密度,促使金刚石膜快速沉积。图中CVD金刚石膜还附着在硅基底表面,还需要后期剥离、切割、研磨和抛光处理,最终得到一块镜面抛光的CVD金刚石膜。
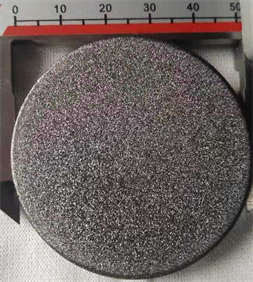
Figure 6. Raman spectra (a) and picture (b) of the 2 inch diamond film
图6. 金刚石膜的Raman光谱图(a),2 inch金刚石膜的图片(b)
5. 结论
在15 kW@2450 MHz的高功率MPCVD装置放电生成等离子体制备金刚石膜的工艺中,采用光学发射光谱和Raman光谱分别探究气压和甲烷体积分数对金刚石膜沉积速率和质量的影响,发现随着气压的增加,等离子体中的C2基团和原子氢的相对强度比值(IC2/IHa)增大,金刚石膜的沉积速率提高,在气压为14 kPa时,沉积的金刚石膜在保证沉积速率的前提下还有很好的结晶质量,当CH4体积分数增加,金刚石膜的沉积速率也会加快,但随着IC2/IHa值增大,金刚石膜中出现了石墨相,膜纯度降低,质量变差;在微波输出功率为12 kW,基片温度在850℃,压强为14 kPa,CH4体积分数为1%时制备出厚度为1.6 mm的高质量金刚石膜。
基金项目
四川省科技计划资助重点研发项目(2019YFG0115)。