1. 引言
电连接器作为型号系统中实现电信号传输的主要元件,广泛应用于航空航天、国防、军事等领域。电连接器按结构外形可分为:矩形电连接器、圆形电连接器和印制板电连接器,按用途可分类为:低频电连接器、高频电连接器、分离脱落电连接器等 [1] 。虽然电连接器的种类丰富,但接触件永远是电连接器实现电信号传输的核心元件,其接触可靠性直接决定了电连接器的寿命。
目前,国内外对电连接器可靠性的研究大多聚焦于圆形和矩形电连接器,而对于印制板类型电连接器的可靠性研究很少。陈文华等 [2] 利用极值分布理论推导出航天电连接器的寿命分布模型,通过综合应力加速寿命试验,求得了Y11X系列航天电连接器在环境温度和振动应力综合作用下的可靠性指标。潘骏等 [3] 基于Winner过程建立了随机振动应力作用下电连接器的接触性能退化模型,通过开展步进应力加速退化试验,给出了接触件寿命和振动量级间的关系,实现了振动环境下电连接器接触件可靠性的快速评估。Yi Ren等 [4] 提出了圆形电连接器的失效物理模型和可靠性评估的一些问题,并提出了一种结合加速退化试验和失效物理建模的新方法。Wang等 [5] 提出了一种连接器可靠性评估的系统方法,并通过将其应用于片簧连接器,验证了该方法的有效性。
基于此,本文以某型号印制板电连接器为研究对象,通过对电连接器的失效机理分析,建立了接触对的性能退化轨迹模型,并通过恒定应力加速退化试验,实现了该电连接器在贮存环境下的可靠寿命评估。
2. 电连接器的失效机理分析
某型号印制板电连接器由接触件和绝缘件组成,其接触件由长方体的插针和片簧式插孔组成。贮存环境下电连接器失效模式主要包括三种:接触失效、绝缘失效和机械连接失效,其中,接触失效是电连接器失效的最主要原因。接触件表面氧化膜层的增长是接触失效的主要原因 [6] 。
接触件的基底材料为铜,表面镀金,但限于经济成本,镀金层很薄,所以镀层表面难免会存在孔隙等缺陷,从而使空气中的
和
穿过镀层接触到基底材料,在基底材料与镀层之间发生氧化反应
,生成
薄膜。温度会显著影响氧化膜层的生长速度,这是因为温度升高会使
的内能增大,从而加速
向镀层表面的扩散,加快氧化反应。随着
膜层厚度的不断增加,接触电阻也不断增大,最终造成电连接器的接触失效。
3. 接触对的性能退化轨迹模型
接触对的接触电阻由三部分组成:材料本身的体电阻
、接触斑点的收缩电阻
和接触斑点的膜层电阻
。即
(1)
由失效机理可知,电连接器的接触失效是由于膜层电阻的增长导致,而体电阻与收缩电阻主要由其材料、结构及工艺参数决定,当接触件出厂后,这些参数已经确定,可将其视为定值,记为
,则接触电阻可进一步表示为
(2)
P.Barkan通过对接触电阻的研究 [7] ,建立了膜层电阻的计算公式
(3)
式中,
为接触压力,
为膜的隧道电阻率,H为镀层材料表面的硬度。
根据德提琪、费希尔对隧道效应的理论研究 [6] ,膜的隧道电阻率
与膜层平均厚度
满足关系
(4)
式中,
、c为常数。
随着膜层厚度
的不断增长,通过膜的
和
不断减少,膜层的生长速度会逐渐变慢,因此,膜层厚度
与时间t的关系可表示为 [8]
(5)
式中,
为反应速率常数,只与温度有关。
这里认为接触表面各孔隙形状近似为圆形,且氧化膜层会随着时间变得越均匀。若接触区的孔隙率用
表示,接触面积用
来表示,则t时刻氧化膜的平均厚度为
(6)
式中,
为单个孔隙生成的氧化物体积,
为单个孔隙的平均半径。
由式(3)~(6)可得膜层电阻的表达式
(7)
将式(7)代入式(5)中,即可得接触对的性能退化轨迹模型
(8)
为了便于应用,将模型进行简化,令
(9)
则式(11)可转化为
(10)
式中,
为接触电阻的初值,β为常数,α为接触电阻退化率。
4. 加速退化试验方案设计
按照试验应力不改变样品的失效机理为准则,并结合前期的试验经验和试验设备提供的应力范围 [9] ,确定本试验的三个应力水平
、
、
、
。为了保证试验数据统计分析的精度,每个应力水平下样本量不能少于5个,考虑到试验的成本,应力水平
、
、
和
下样本数分别为13、11、11和6个。根据高应力下短间隔、低应力下长间隔的原则,确定各应力水平下的测试时间间隔。具体的试验方案如表1所示。

Table 1. Accelerated degradation test scheme
表1. 加速退化试验方案
为了判别样品在实验过程中是否失效,根据相关电连接器产品手册的规定,确定其失效判据为:任意接触对的接触电阻 > 20 mΩ。由于低电阻值的测量需要消除导线电阻的影响,所以本文采用开尔文四线法对接触电阻进行测量,其测试原理如图1所示。

Figure 1. Test schematic diagram of contact resistance
图1. 接触电阻的测试原理图
图中,
、
、
、
为导线的电阻。试验的测试装置如图2所示。整个试验测试过程中,测试电压始终为5 V,电流为1 A。

Figure 2. Test device of contact resistance
图2. 接触电阻的测试装置
为了更直观的展示试验样品接触电阻的退化情况,从每组应力水平中随机挑选1个试验样品进行展示,每个样品中包含有80个接触对,接触电阻退化轨迹如图3所示,从图中可以看出各个温度下样品的接触电阻随着试验时间都发生了明显的退化,图例中的编号代表每个样品接触对的编号。
 (a) 105℃样品9
(a) 105℃样品9  (b) 120℃样品11
(b) 120℃样品11  (c) 140℃样品4
(c) 140℃样品4  (d) 158℃样品2
(d) 158℃样品2
Figure 3. The contact resistance degradation trace of the test sample at each stress level
图3. 各应力水平下试验样品的接触电阻的退化轨迹
5. 试验数据的统计分析
5.1. 寿命分布类型的确定
由于投入试验的所有样品均未出现接触失效,因此需要通过退化轨迹模型来计算每个试验样品的伪寿命。这里以158℃试验样品为例来计算其模型参数,其他应力水平按照相同的方法进行计算。利用最小二乘法将加速退化试验获得的退化数据与式(10)进行拟合,可得到每个接触对的退化模型参数
和
,然后根据失效阈值求出各个接触对的伪寿命,选取每个样品中接触对伪寿命的最小值作为该样品的伪寿命。158℃试验样品伪寿命的计算结果如表2所示。

Table 2. Pseudo life time of the test sample at 158℃
表2. 158℃试验样品伪寿命
目前工程上常见的寿命分布类型有正态分布、威布尔分布、对数正态分布、伽马分布和指数分布等。
利用Anderson-Darling拟合优度检验方法对伪寿命数据进行最优拟合分布检验 [10] ,检验结果如图4所示。
拟合优度检验结果如表3所示,其中P值大于0.05则表明数据服从该分布;AD值越小,说明数据对该分布的拟合越好,根据拟合优度结果表明,158℃样品的伪寿命数据更服从对数正态分布。其它应力水平也采用相同的方法进行计算和检验,结果表明每个应力水平下的寿命分布函数都服从对数正态分布。因此本文利用对数正态分布函数来求得该型号印制板电连接器的可靠寿命。

Figure 4. Distribution test plot for pseudo lifetime of 158℃ sample
图4. 158℃下样品伪寿命的分布检验图

Table 3. Thegoodness-of-fit test results for pseudo lifetime of 158℃ samples
表3. 158℃样品伪寿命的拟合优度检验结果
5.2. 寿命分布模型参数的极大似然估计
对数正态分布的概率密度函数为
(11)
建立其似然函数
(12)
通过Matlab编程计算可求得158℃下样品寿命分布参数的估计值:
,
。其他应力水平下的寿命分布参数的估计值采用相同的方法进行求解,计算结果如表4所示。

Table 4. The estimated values of the life distribution parameters at each stress level
表4. 各应力水平下的寿命分布参数的估计值
5.3. 贮存温度下的参数估计
根据试验情况,可做如下假设:
1) 电连接器在贮存温度下的寿命分布类型与加速退化温度应力下的寿命分布相同,即都服从于对数正态分布。
2) 各温度应力下对数标准差σ与温度的变化无关,贮存温度下的对数标准差σ可通过加权平均求得,即
(13)
式中,
、
、
和
为各个试验温度应力下的样品数量。
3) 各温度应力下的对数均值
与温度的关系符合阿伦尼斯方程,即
(14)
式中,a和b为待估参数,T为绝对温度。利用最小二乘法可求得a和b,进而可得到贮存温度下的对数均值为:
(15)
5.4 可靠性评估
由式(11)可得该型号印制板电连接器在贮存温度下的可靠度函数为
(16)
将4.3小节中
与
的估计值带入式(16)中,即可得该型号印制板电连接器在贮存温度(25℃)下的可靠寿命,结果如表5所示。评估结果表明该电连接器满足规定的可靠性要求指标。
贮存温度下的可靠度曲线如图5所示,由可靠度曲线图可以发现:在贮存环境(25℃)下,该印制板电连接器在前480,000小时左右时间段内的接触可靠度大于0.999,即基本认为不会发生接触失效;一直到1,100,000小时左右,电连接器的接触可靠度大于0.9,仍然具有较高的可靠度;在此之后,电连接器的接触可靠度开始随着贮存时间快速下降。

Table 5. Reliable life of a type PCB electrical connector in storage environment
表5. 某型号印制板电连接器贮存可靠寿命
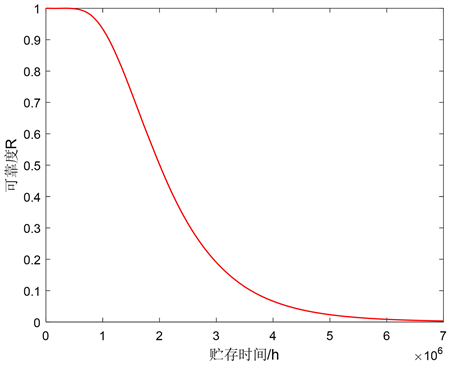
Figure 5. Reliability curve of a type PCB electrical connector in storage environment
图5. 某型号印制板电连接器的贮存可靠度曲线
6. 总结
本文以某型号印制板电连接器为研究对象,分析了其在贮存环境下的接触失效的主要原因是由于接触件表面氧化膜层的增长所致,并基于氧化膜层的增长规律,建立了电连接器接触对的性能退化轨迹模型;通过开展以温度为加速应力的恒定应力加速退化试验,寿命样品的接触性能退化数据,利用样品的伪寿命,成功地对该型号印制板电连接器的贮存寿命进行了评估,不仅减少了试验时间、节省了试验的费用,还为其他同类型号电连接器的可靠性评估提供了理论依据。
基金项目
浙江省重点研发项目(2021C01133)。
参考文献
NOTES
*通讯作者。